QR kód

Produkty
Kontaktuj nás


Fax
+86-579-87223657

E-mail

Adresa
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Silikónová epitaxiaje kľúčovým základným procesom v modernej výrobe polovodičov. Vzťahuje sa na proces pestovania jednej alebo viacerých vrstiev monokryštálových kremíkových tenkých vrstiev so špecifickou kryštálovou štruktúrou, hrúbkou, koncentráciou dopingu a typom na presne vyleštenom monokryštálovom kremíkovom substráte. Tento narastený film sa nazýva epitaxná vrstva (Epitaxial Layer alebo Epi Layer) a kremíkový plátok s epitaxnou vrstvou sa nazýva epitaxný kremíkový plátok. Jeho základnou charakteristikou je, že novo narastená epitaxná kremíková vrstva je pokračovaním mriežkovej štruktúry substrátu v kryštalografii, pričom si zachováva rovnakú orientáciu kryštálov ako substrát a vytvára dokonalú monokryštálovú štruktúru. To umožňuje, aby mala epitaxná vrstva presne navrhnuté elektrické vlastnosti, ktoré sú odlišné od vlastností substrátu, čím sa poskytuje základ pre výrobu vysokovýkonných polovodičových zariadení.
![]()
Vertikálny epitaxný susceptor pre silikónovú epitaxiu
1) Definícia: Silikónová epitaxia je technológia, ktorá ukladá atómy kremíka na monokryštálový kremíkový substrát chemickými alebo fyzikálnymi metódami a usporadúva ich podľa mriežkovej štruktúry substrátu, aby sa vytvoril nový tenký film monokryštálového kremíka.
2) Priraďovanie mriežky: Hlavnou črtou je usporiadanosť epitaxného rastu. Nanesené atómy kremíka nie sú náhodne naskladané, ale sú usporiadané podľa kryštálovej orientácie substrátu pod vedením „šablóny“, ktorú poskytujú atómy na povrchu substrátu, čím sa dosiahne presná replikácia na úrovni atómov. To zaisťuje, že epitaxná vrstva je vysokokvalitný monokryštál, a nie polykryštalický alebo amorfný.
3) Ovládateľnosť: Proces kremíkovej epitaxie umožňuje presnú kontrolu hrúbky rastovej vrstvy (od nanometrov po mikrometre), typu dopingu (typu N alebo typu P) a koncentrácie dopingu. To umožňuje vytvárať oblasti s rôznymi elektrickými vlastnosťami na rovnakej kremíkovej doštičke, čo je kľúčom k výrobe zložitých integrovaných obvodov.
4) Charakteristiky rozhrania: Medzi epitaxnou vrstvou a substrátom sa vytvorí rozhranie. V ideálnom prípade je toto rozhranie atómovo ploché a bez kontaminácie. Kvalita rozhrania je však rozhodujúca pre výkon epitaxnej vrstvy a akékoľvek defekty alebo kontaminácia môžu ovplyvniť konečný výkon zariadenia.
Epitaxný rast kremíka závisí hlavne od poskytnutia správnej energie a prostredia pre atómy kremíka na migráciu na povrchu substrátu a nájdenie polohy mriežky s najnižšou energiou pre kombináciu. Najpoužívanejšou technológiou v súčasnosti je chemická depozícia z plynnej fázy (CVD).
Chemická depozícia z pár (CVD): Toto je hlavná metóda na dosiahnutie kremíkovej epitaxie. Jeho základné princípy sú:
● Prekurzorová doprava: Plyn obsahujúci kremíkový prvok (prekurzor), ako je silán (SiH4), dichlórsilán (SiH2Cl2) alebo trichlórsilán (SiHCl3), a dopačný plyn (ako je fosfín PH3 pre doping typu N a diborán B2H6 pre dopovanie typu P) sa zmiešajú v presných pomeroch a vedú do reakčnej komory s vysokou teplotou.
● Povrchová reakcia: Pri vysokých teplotách (zvyčajne medzi 900 °C a 1200 °C) tieto plyny podliehajú chemickému rozkladu alebo reakcii na povrchu zahriateho kremíkového substrátu. Napríklad SiH4->Si (tuhá látka) + 2H2 (plyn).
● Povrchová migrácia a nukleácia: Atómy kremíka produkované rozkladom sa adsorbujú na povrch substrátu a migrujú po povrchu, prípadne nájdu správne miesto mriežky, aby sa spojili a začali tvoriť nový jedinýkryštálovej vrstvy. Kvalita epitaxného rastového kremíka závisí vo veľkej miere od kontroly tohto kroku.
● Vrstvený rast: Novo nanesená atómová vrstva nepretržite opakuje mriežkovú štruktúru substrátu, rastie vrstvu po vrstve a vytvára epitaxnú vrstvu kremíka so špecifickou hrúbkou.
Kľúčové parametre procesu: Kvalita procesu kremíkovej epitaxie je prísne kontrolovaná a kľúčové parametre zahŕňajú:
● Teplota: ovplyvňuje rýchlosť reakcie, pohyblivosť povrchu a tvorbu defektov.
● Tlak: ovplyvňuje transport plynu a reakčnú cestu.
● Prietok a pomer plynu: určuje rýchlosť rastu a koncentráciu dopingu.
● Čistota povrchu podkladu: Pôvodcom chýb môže byť akákoľvek kontaminácia.
● Iné technológie: Hoci CVD je hlavným prúdom, technológie ako Molecular Beam Epitaxy (MBE) možno použiť aj na kremíkovú epitaxiu, najmä vo výskume a vývoji alebo špeciálnych aplikáciách, ktoré vyžadujú extrémne vysokú presnosť riadenia.MBE priamo odparuje zdroje kremíka v prostredí ultravysokého vákua a atómové alebo molekulárne lúče sú priamo premietané na substrát pre rast.
Technológia kremíkovej epitaxie výrazne rozšírila rozsah použitia kremíkových materiálov a je nevyhnutnou súčasťou výroby mnohých pokročilých polovodičových zariadení.
● Technológia CMOS: Vo vysokovýkonných logických čipoch (ako sú CPU a GPU) sa nízko dopovaná (P- alebo N-) epitaxná kremíková vrstva často pestuje na silne dotovanom (P+ alebo N+) substráte. Táto epitaxná silikónová doštičková štruktúra môže účinne potlačiť blokovací efekt (Latch-up), zlepšiť spoľahlivosť zariadenia a zachovať nízky odpor substrátu, čo prispieva k vedeniu prúdu a rozptylu tepla.
● Bipolárne tranzistory (BJT) a BiCMOS: V týchto zariadeniach sa silikónová epitaxia používa na presnú konštrukciu štruktúr, ako je oblasť bázy alebo kolektora, a zisk, rýchlosť a ďalšie charakteristiky tranzistora sú optimalizované riadením koncentrácie dopingu a hrúbky epitaxnej vrstvy.
● Obrazový snímač (CIS): V niektorých aplikáciách obrazových snímačov môžu epitaxné kremíkové doštičky zlepšiť elektrickú izoláciu pixelov, znížiť presluchy a optimalizovať účinnosť fotoelektrickej konverzie. Epitaxná vrstva poskytuje čistejšiu a menej poškodenú aktívnu oblasť.
● Pokročilé procesné uzly: Keďže veľkosť zariadenia sa neustále zmenšuje, požiadavky na vlastnosti materiálu sú stále vyššie a vyššie. Technológia kremíkovej epitaxie, vrátane selektívneho epitaxného rastu (SEG), sa používa na pestovanie epitaxných vrstiev namáhaného kremíka alebo kremíka germánia (SiGe) v špecifických oblastiach, aby sa zlepšila mobilita nosiča a tým sa zvýšila rýchlosť tranzistorov.
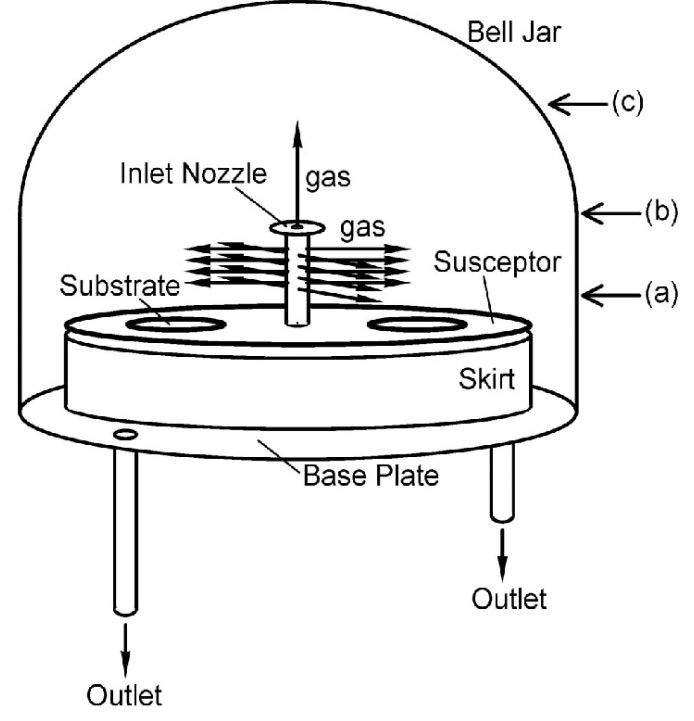
Horizontálny epitaxný susceptor pre silikónovú epitaxiu
Hoci technológia kremíkovej epitaxie je vyspelá a široko používaná, stále existujú určité výzvy a problémy v epitaxnom raste procesu kremíka:
● Kontrola defektov: Počas epitaxného rastu môžu vzniknúť rôzne defekty kryštálov, ako sú stohovacie chyby, dislokácie, sklzové línie atď. Tieto chyby môžu vážne ovplyvniť elektrický výkon, spoľahlivosť a výťažnosť zariadenia. Kontrola defektov vyžaduje extrémne čisté prostredie, optimalizované parametre procesu a vysokokvalitné podklady.
● Jednotnosť: Dosiahnutie dokonalej rovnomernosti hrúbky epitaxnej vrstvy a koncentrácie dopingu na veľkých kremíkových plátkoch (napríklad 300 mm) je neustálou výzvou. Nerovnomernosť môže viesť k rozdielom vo výkone zariadenia na rovnakom plátku.
● Autodoping: Počas procesu epitaxného rastu môžu dopujúce látky s vysokou koncentráciou v substráte vstúpiť do rastúcej epitaxnej vrstvy difúziou v plynnej fáze alebo difúziou v tuhom skupenstve, čo spôsobí, že sa koncentrácia dopingu v epitaxnej vrstve odchyľuje od očakávanej hodnoty, najmä v blízkosti rozhrania medzi epitaxiálnou vrstvou a substrátom. Toto je jeden z problémov, ktorý je potrebné riešiť v procese kremíkovej epitaxie.
● Morfológia povrchu: Povrch epitaxnej vrstvy musí zostať vysoko plochý a akákoľvek drsnosť alebo povrchové defekty (ako je zákal) ovplyvnia následné procesy, ako je litografia.
● náklady: V porovnaní s bežnými leštenými kremíkovými doštičkami, výroba epitaxných kremíkových doštičiek pridáva ďalšie procesné kroky a investície do zariadenia, čo vedie k vyšším nákladom.
● Výzvy selektívnej epitaxie: Pri pokročilých procesoch kladie selektívny epitaxný rast (rast len v špecifických oblastiach) vyššie nároky na riadenie procesu, ako je selektivita rýchlosti rastu, kontrola laterálneho prerastania atď.
Ako kľúčová technológia prípravy polovodičového materiálu, základná vlastnosťsilikónová epitaxiaje schopnosť presne pestovať vysokokvalitné monokryštálové epitaxné kremíkové vrstvy so špecifickými elektrickými a fyzikálnymi vlastnosťami na monokryštálových kremíkových substrátoch. Prostredníctvom presného riadenia parametrov, ako je teplota, tlak a prúdenie vzduchu v procese kremíkovej epitaxie, možno hrúbku vrstvy a distribúciu dopingu prispôsobiť tak, aby vyhovovali potrebám rôznych polovodičových aplikácií, ako sú CMOS, výkonové zariadenia a senzory.
Hoci epitaxný rast kremíka čelí výzvam, ako je kontrola defektov, uniformita, samodoping a náklady, s neustálym pokrokom v technológii je kremíková epitaxia stále jednou z hlavných hnacích síl na podporu zlepšovania výkonu a funkčnej inovácie polovodičových zariadení a jej pozícia vo výrobe epitaxných kremíkových doštičiek je nenahraditeľná.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Čína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Všetky práva vyhradené.
Links | Sitemap | RSS | XML | Zásady ochrany osobných údajov |
